Туннельные диоды.
Электроника

Рассмотрение работы туннельных диодов для простоты проведем при температуре абсолютного нуля. В этом случае выше уровня Ферми все разрешенные энергетические состояния по обеим сторонам перехода являются свободными, а ниже уровня Ферми — заполненными электронами (рис. 3.8, а). В отсутствие приложенного напряжения (С/ = 0 на рис. 3.8, а) туннельный ток через переход не протекает, поскольку… Читать ещё >
Туннельные диоды. Электроника (реферат, курсовая, диплом, контрольная)
Работа туннельных диодов основана на явлении квантовомеханического туннелирования основных носителей через потенциальный барьер, энергия которого превышает энергию носителей.
Время туннелирования (т.г) определяется вероятностью квантово-механического перехода в единицу времени, которое пропорционально ехр [-2/г (0)И^], где IV — ширина потенциального барьера, /г (0) — среднее значение волнового вектора носителя заряда в процессе туннелирования, приходящееся на один носитель с нулевым поперечным импульсом и энергией, равной энергии Ферми.
Время туннелирования тт чрезвычайно мало, и поэтому туннельные приборы используются в СВЧ-диапазоне в качестве генераторов, переключателей, для туннельной спектроскопии и т. д.
Поскольку вероятность туннельного перехода сильно зависит от ширины потенциального барьера IV, то в туннельных диодах используются р—п переходы, образуемые вырожденными полупроводниками, т. е. полупроводниками с концентрацией примеси порядка 1020…Ю21 см-3. Из-за сильного легирования уровень Ферми располагается внутри зоны проводимости (для ц области) и внутри валентной зоны (для р-области), как это показано на рис. 3.8, а, диаграмма 2. Ширина обедненного слоя (ширина р—п-перехода) при указанной степени легирования составляет величину ~ 100 ангстрем (А) и менее.
Рассмотрение работы туннельных диодов для простоты проведем при температуре абсолютного нуля. В этом случае выше уровня Ферми все разрешенные энергетические состояния по обеим сторонам перехода являются свободными, а ниже уровня Ферми — заполненными электронами (рис. 3.8, а). В отсутствие приложенного напряжения (С/ = 0 на рис. 3.8, а) туннельный ток через переход не протекает, поскольку туннелирование частиц в данном случае не имеет места, так как туннельный переход происходит без изменения энергии частицы, а при и — 0 уровни одинаковой энергии в обеих областях или свободны (расположены выше Еф, Еф), или заняты (расположены ниже.
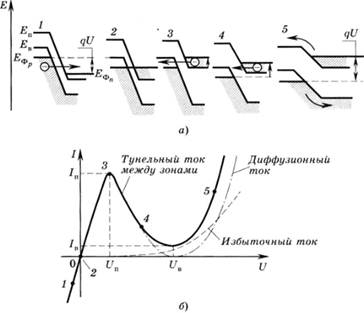
Рис. 3.8.
Еф и Еф). На ВАХ (рис. 3.8, б) рассматриваемому случаю соответствует точка 2, а на рис. 3.8, а — диаграмма 2.
При подаче напряжения происходит туннелирование электронов с занятых состояний валентной зоны р полупроводника на свободные состояния л полупроводника (обратное смещение, точка 1 на ВАХ рис. 3.8, б, диаграмма 1 на рис. 3.8, а) или, наоборот, с занятых состояний л полупроводника на свободные уровни р полупроводника (прямое смещение, точка 3 на рис. 3.8, б> диаграмма 3 на рис. 3.8, а). Для реализации указанных туннельных переходов необходимо выполнение следующих условий:
- 1) наличие заполненных состояний в области, откуда электроны туннелируют;
- 2) наличие свободных состояний с теми же значениями энергии в области, куда электроны туннелируют;
- 3) ширина потенциального барьера должна быть как можно меньше (сравнима с длиной волны де Бройля) для того, чтобы вероятность туннелирования была как можно больше;
- 4) квазиимпульс туннелирующих электронов должен сохраняться при переходе.
При подаче любого обратного напряжения занятые состояния в валентной зоне в р-области всегда перекрываются со свободными уровнями в п-области, поэтому обратный ток резко нарастает при увеличении абсолютного значения обратного напряжения, как это видно из ВАХ (рис. 3.8, б).
При прямом напряжении существуют значения энергий, при которых состояния в п области заполнены, а разрешенные состояния в р области пусты. На рис. 3.8, а и 3.8, б (диаграмма 3, точка 3 на ВАХ) изображен случай, когда перекрытие занятых состояний «области (ниже уровня Еф) и свободных состояний р области (выше уровня Еф) максимально, что соответствует набольшему туннельному току /п при прямом смещении И и = ип (точка 3 на ВАХ, рис. 3.8, б). В этом случае электроны туннелируют с уровней ниже Еф п-области на уровни выше Еф р области (диаграмма 3 на рис. 3.8, а).
При увеличении или уменьшении напряжения и > 1/п или и < 11п (Цп соответствует току /п) перекрытие занятых и свободных состояний становится меньше и туннельный ток падает (например, точка 4 на ВАХ, диаграмма 4). Если напряжение на переходе и > ?/в, занятые состояния в валентной зоне р-области соответствуют по энергии уровням в запрещенной зоне, в результате чего туннельный ток падает до нуля. При дальнейшем увеличении напряжения и > Г/в через р—" переход будет протекать обычный диффузионный ток (например, точка 5 на ВАХ, энергетическая диаграмма 5). Таким образом, при увеличении прямого напряжения туннельный ток сначала нарастает от нуля до максимального значения /п, а затем уменьшается до нуля, когда приложенное прямое напряжение удовлетворяет условию и = ип + V (диаграмма 5), где 1/п = (Еф — Еп)/д — степень вырождения «области, и = (Еф — ?»)/</— степень вырождения р области.
В рассмотренном идеальном туннельном диоде туннельный ток уменьшается до нуля при напряжениях ии > Vп + С/р, и при и > ип через диод протекает обычный ток инжекции неосновных носителей. Однако реально ток при и > ?/в существенно превышает обычный диодный ток, т. е. существует некий «избыточный ток» через туннельный диод при и в ив. Основная причина избыточного тока состоит в туннелировании носителей через энергетические состояния, расположенные в запрещенной зоне. Итак, в туннельном диоде полный ток складывается из трех составляющих: туннельного тока Д5 при и < 17 в> избыточного тока уи8 при и ~ ив, т. е. в окрестности ив, и диффузионного уд8, который преобладает при С/ > 1/в.
Статическая ВАХ определяется суммой этих трех компонент тока.

где у = 1/8 — плотность тока, 8 — площадь перехода, 17 п, ив — соответственно напряжение, соответствующее пиковому току /п = уп8, и напряжение впадины, при котором ток впадины /в =.
= ув8, А = 4/3(т* е/АГ*), т * — эффективная масса электрона в направлении туннелирования, е— диэлектрическая проницаемость полупроводника, А/* = [(А^аА^д)/(А^а + Nд) — эффективная степень легирования, АГД, АГа — концентрации доноров и акцепторов соответственно, <�рг = ИТ/ц — тепловой потенциал, у0 — плотность теплового тока.
Туннельные диоды могут быть изготовлены из многих полупроводников, при этом отношение токов Ь = /п//в для различных материалов различается следующим образом: Ь = 8 для Се, 6=12 для СаАэ, СаЗЬ, 6 = 4 для вц Ь = 12 для Оа0 7А10 3Ав. В общем случае величина Ь возрастет при увеличении уровня легирования.
Статические параметры туннельного диода. Специфические параметры туннельных диодов связаны с особенностями его ВАХ. К ним относятся: пиковый ток — /п, который для туннельных диодов лежит в диапазоне от десятых долей до сотен миллиампер; ток впадины — /в, который при увеличении /п определяется из значения коэффициента Ь; напряжение пика С/п, которое для СаАв-дйодов равно 100—150 мВ, для Ое-дйодов 17п = 40…60 мВ; напряжение впадины ив: (Ув = 400…500 мВ для СаАя и 250…350 мВ для Се. Помимо указанных параметров для туннельного диода (как ВЧ, так и СВЧ-приборов), важны параметры, определяющие его эквивалентную схему или вытекающие из нее. Эквивалентная схема туннельного диода для падающего участка ВАХ.
(между точками 3 и 4 на рис. 3.8, а) представлена на рис. 3.9. Резистор г_ — дифференциальное отрицательное сопротивление р—/г перехода, гпот — сопротивление потерь, определяемое сопротивлениями областей пир диода контактов и выводов, — индуктивность выводов, С = Сбар — емкость диода при фиксированном напряжении на переходе, гпот «гв (сопротивление выводов и контактов).
Импеданс приведенной на рис. 3.9 схемы равен.
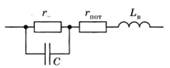
Рис. 3.9.

Из формулы (3.2) видно, что активная и реактивная составляющие импеданса при некоторых значениях частот со = 2л/ равны нулю, при этом эти частоты различны для этих составляющих полного импеданса. Частота, при которой активная составляющая равна нулю, называется предельной резистивной частотой /д

Резонансная частота /0 туннельного диода соответствует равенству нулю реактивной составляющей полного импеданса.

При разработке туннельных диодов закладывается условие /0 > /Л. В результате возможные паразитные резонансы могут возникать только на частотах, на которых диод не обладает отрицательным дифференциальным сопротивлением. Из указанного неравенства следует ограничение на индуктивность Ьь < |г_|гпотС, что достигается использованием коаксиальной или волноводной таблеточной конструкции корпуса.
Обращенный диод. Если концентрации легирующих примесей таковы, что р и я области близки к вырождению либо слабо вырождены, то при малых прямых и обратных смещениях ток в прямом направлении меньше тока в обратном. Отсюда возникает название такого туннельного диода — обращенный диод. В равновесии уровень Ферми в обращенном диоде близок к границам зон разрешенной энергии, т. е. к потолку валентной зоны р-области и дну зоны проводимости я-области.

Рис. 4.0.
При обратном смещении электроны легко туннелируют из валентной зоны р области в зону проводимости л области, что будет приводить к возрастанию туннельного тока с ростом абсолютного значения обратного напряжения. В результате обратная ветвь ВАХ обращенного диода аналогична ВАХ туннельного диода (рис. 3.10, а, б). При подаче прямого напряжения ток в обращенном диоде определяется инжекцией носителей заряда через переход подобно обычному диоду. При малых прямых напряжениях и < 0,5 В прямой ток в обращенном диоде значительно меньше обратного. За счет избыточного туннельного тока в обращенных диодах возможны слабые проявления туннельного эффекта при прямых смещениях (см. рис. 3.10, а). Обращенные диоды можно использовать в качестве детекторов малых сигналов СВЧ-излучения, смесителей, переключателей.
Обращенные диоды имеют хорошие частотные характеристики, поскольку их работа не сопровождается накоплением неосновных носителей, и малый 1//шум (см. гл. 22). ВАХ этого типа диодов не чувствительна к влиянию температуры и облучения.
Помимо рассмотренных приборов, туннельный эффект используется также в МДП-диодах (структура металл — диэлектрик — полупроводник) при толщине диэлектрика от 10 до 50 А, в МДМ-диодах (структура металл — диэлектрик — металл) и туннельных транзисторах на основе МДП и МДМ структур.