Формирование канала в МДП-транзисторах

Рассмотрим процессы в МДП-структуре, которая сформирована в области затвора и состоит из металлического слоя затвора, тонкого диэлектрического слоя, подложки р типа проводимости и металлического электрода, образующего вывод подложки (рис. 6.2, б). Сначала предположим, что на исток и сток напряжение не подается и их цепи объединены с подложкой (см. рис. 6.2, б). Напряжение будет прикладываться… Читать ещё >
Формирование канала в МДП-транзисторах (реферат, курсовая, диплом, контрольная)
Устройство МДП-транзистора с индуцированным каналом представлено на рис. 6.2, а, где 1 — подложка, 2 — область истока, 3 — вывод истока, 4 — диэлектрический слой 8Ю2> 5 — затвор, 6 — индуцированный канал (или область формирования канала), 7 — сток, 8 — область стока, Ь — длина канала, 51, — область перекрытия с 2 и 8 (см. также рис. 6.10). Если напряжение на затворе отсутствует, то в исходном состоянии канал не существует.
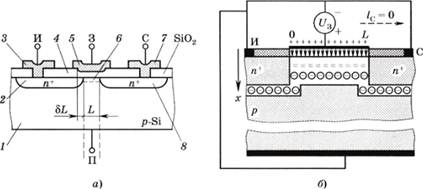
Рис. 6.2.
Рассмотрим процессы в МДП-структуре, которая сформирована в области затвора и состоит из металлического слоя затвора, тонкого диэлектрического слоя, подложки р типа проводимости и металлического электрода, образующего вывод подложки (рис. 6.2, б). Сначала предположим, что на исток и сток напряжение не подается и их цепи объединены с подложкой (см. рис. 6.2, б). Напряжение будет прикладываться между затвором и подложкой. Для простоты будем также считать, что работа выхода полупроводника и металла одинакова и контактная разность потенциалов между ними равна нулю, поверхностный заряд на границе раздела полупроводник—диэлектрик отсутствует, а концентрация атомов акцепторов в подложке одинакова по всему объему.
Рассматриваемая структура подобна конденсатору с обкладками из металла и полупроводника р типа. Если к затвору приложить относительно подложки отрицательный потенциал (металл заряжается отрицательно), то на границе полупроводника с диэлектриком появляется индуцированный положительный заряд, который возникает за счет дырок, притянутых из объема электрическим полем, создаваемым внешним отрицательным зарядом. В диэлектрике свободных носителей заряда нет, поэтому напряженность электрического поля в нем одинакова по объему. В полупроводнике концентрация избыточных носителей максимальна у поверхности и уменьшается по мере удаления от нее в глубину объема по направлению к выводу подложки. В результате объемный положительный заряд создает в приповерхностной области электрическое поле, направленное навстречу внешнему полю, что уменьшает результирующее поле. Такой режим работы МДП-структуры называется режимом обогащения, поскольку в приповерхностном слое полупроводника концентрация дырок рпов будет больше концентрации атомов акцепторов (Риов > W")* чем в глубине полупроводника, где р0 = Nn. Напряженность поля спадает по экспоненте exp (-x/LD) по мере удаления от поверхности (координата х направлена от поверхности в глубь полупроводника).
Параметр LD = [(?()?Фт'/<7^а)]½ называется дебаевской длиной экранирования. Толщина обогащенного слоя порядка LD. При х > (2…3)Ld электрическое поле практически отсутствует из-за экранировки внешнего поля избыточным зарядом дырок рпов.
При подаче на затвор положительного потенциала в приповерхностном слое р-полупроводника реализуются режимы обеднения и инверсии (см. рис. 6.2, б). В режиме обеднения электрическое поле вытесняет дырки от поверхности полупроводника вглубь и их концентрация в этой области уменьшается, но концентрация неосновных носителей (в данном случае электронов) начинает возрастать (рис. 6.3, а, б). Однако концентрация их остается низкой, поэтому у поверхности полупроводника образу;

Рис. 6.3.
ется обедненный основными носителями СЛОЙ Ь^у в котором раов и «пов меньше ^Уа и существует отрицательный заряд нескомпенсированных акцепторных ионов с приблизительно постоянной объемной плотностью X (рис. 6.3, в). Напряженность электрического поля? вне обедненного слоя при х > Ьцъ равна нулю (рис. 6.3, г). Из-за наличия отрицательного объемного заряда возникает поверхностный потенциал <�рпов (рис. 6.3, д), который определяется разностью потенциалов между поверхностью на границе диэлектрик—полупроводник и координатами х > Ь()б, где отсутствует электрическое поле. Толщина обедненного слоя ЬоЬ может быть определена на основе решения уравнения Пуассона, в результате получается выражение, аналогичное формуле (2.11) для несимметричногор—п-перехода (см. [2], п. 1.8):

Поверхностные концентрации дырок и электронов связаны со значением поверхностного потенциала <�рпов и могут быть вычислены согласно следующим выражениям:

По формулам (6.3) концентрацию зарядов в приповерхностном слое можно вычислять и для других режимов (обогащения и инверсии).
Режим обеднения существует при «пов < Ыау когда поверхностный потенциал фппп превышает пороговое значение.

При АГа = 1016 см" 3 и Т — 300 К для фпор = 0,7 В.
Величина српор достигается при соответствующем пороговом напряжении (7пор на затворе. При (/3 = ?/пор концентрация электронов в приповерхностном слое «пов = 7Уа. Если же > С/пор в МДП-структуре реализуется режим инверсии у при котором «пов > (см. рис. 6.3, а, бу в), т. е. у поверхности образуется хорошо проводящий инверсный слой с типом проводимости, противоположным типу проводимости подложки, который выполняет роль канала (см. рис. 6.2, а, б). Под инверсным слоем располагается обедненная область, а далее подложка р-типа (см. рис. 6.2, а, б). На рис. 6.3 (б, в, г, д) показаны распределения в указанных слоях (областях) концентрации свободных носителей р, пу объемного заряда ионов акцепторов А. = <�уЛ^а, напряженности { и потенциала электрического поля <�р. Скачок напряженности электрического поля (см. рис. 6.3, г) на границе раздела 81—8Ю2 (х = 0) обусловлен различием диэлектрической проницаемости 81 и 8Ю2.
По мере удаления от поверхности (х > 0) напряженность электрического поля и концентрация электронов уменьшается, как и в режиме обогащения и обеднения, по закону ехр (-х/Ьп). При Л^п = Ю10 см 3 дебаевская длина равна Ьп = 0,04 мкм. С увеличением |С/3| растет и напряженность электрического поля |6П0В| в инверсном слое, в то время как в обедненном слое она практически не изменяется.
В реальной МДП-структуре на границе 81—8Ю2 существует положительный поверхностный заряд с плотностью Япов. Этот заряд обусловлен тем, что структура поверхности полупроводника характеризуется большим числом дефектов, примесей и адсорбированных атомов различных веществ, формирующих в приповерхностном слое энергетические уровни, расположенные в запрещенной зоне. Эти уровни образуют поверхностные ловушки, которые, захватывая подвижные носители, превращаются в положительные и отрицательные ионы. Поверхностный заряд, образуемый ловушками, непостоянен, так как число заряженных ловушек изменяется в зависимости от напряженности электрического поля у поверхности.
В кремнии, покрытом 8Ю2, вблизи границы раздела существует тонкий переходной слой, содержащий дефекты типа кислородных вакансий, образующих поверхностный положительный заряд ионов в1+ (фпов = 10, 0…Ю12 см-2), который в рассматриваемой структуре является преобладающим. Его влияние в МДII-транзисторах сказывается наиболее сильно.
Поверхностный заряд Япоп создает собственное поле, направленное в ту же сторону, что и поле, обусловленное положительным напряжением на затворе, в результате этого происходит уменьшение порогового напряжения 1/пор.